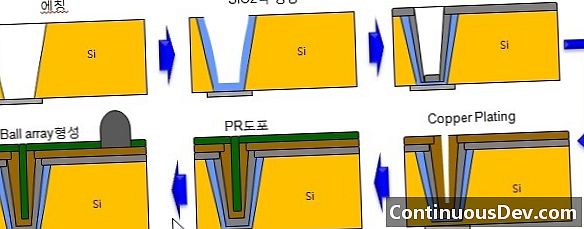
Nilalaman
- Kahulugan - Ano ang ibig sabihin ng Liwat-Silicon Via (TSV)?
- Isang Panimula sa Microsoft Azure at ang Microsoft Cloud | Sa buong gabay na ito, malalaman mo kung ano ang lahat ng cloud computing at kung paano makakatulong ang Microsoft Azure sa iyo upang lumipat at patakbuhin ang iyong negosyo mula sa ulap.
- Ipinapaliwanag ng Techopedia through Liwat-Silicon Via (TSV)
Kahulugan - Ano ang ibig sabihin ng Liwat-Silicon Via (TSV)?
Ang isang through-silikon sa pamamagitan ng (TSV) ay isang uri ng pamamagitan (koneksyon ng vertical na magkakaugnay) na ginamit sa microchip engineering at pagmamanupaktura na ganap na pumasa sa isang silicon die o wafer upang payagan ang pag-stack ng silikon na dice. Ang TSV ay isang mahalagang sangkap para sa paglikha ng 3-D packages at 3-D integrated circuit. Ang ganitong uri ng koneksyon ay gumaganap ng mas mahusay kaysa sa mga kahalili nito, tulad ng package-on-package, dahil ang density nito ay mas mataas at mas maikli ang mga koneksyon nito.Isang Panimula sa Microsoft Azure at ang Microsoft Cloud | Sa buong gabay na ito, malalaman mo kung ano ang lahat ng cloud computing at kung paano makakatulong ang Microsoft Azure sa iyo upang lumipat at patakbuhin ang iyong negosyo mula sa ulap.
Ipinapaliwanag ng Techopedia through Liwat-Silicon Via (TSV)
Sa pamamagitan ng-silikon sa pamamagitan ng (TSV) ay ginagamit sa paglikha ng 3-D na mga pakete na naglalaman ng higit sa isang integrated circuit (IC) na patayo na nakasalansan sa isang paraan na nasasakop ang mas kaunting puwang habang pinapayagan pa rin para sa higit na koneksyon. Bago ang mga TSV, ang mga pakete ng 3-D ay nakasalansan ang mga IC na naka-wire sa mga gilid, na pinataas ang haba at lapad at karaniwang kinakailangan ng isang karagdagang "interposer" na layer sa pagitan ng mga IC, na nagreresulta sa isang mas malaking pakete. Tinatanggal ng TSV ang pangangailangan para sa mga kable at interposer sa gilid, na nagreresulta sa isang mas maliit at pang-flat na package.Ang mga three-dimensional na mga IC ay patayo na nakasalansan na mga chips na katulad ng isang 3-D package ngunit kumilos bilang isang solong yunit, na nagpapahintulot sa kanila na mag-pack ng higit pang mga pag-andar sa medyo maliit na paa. Pinagbuti pa ng TSV ito sa pamamagitan ng pagbibigay ng isang maikling koneksyon sa high-speed sa pagitan ng iba't ibang mga layer.